Halfgeleiderlaser-liftoff-apparatuur zorgt voor een revolutie in het dunner maken van ingots.
Gedetailleerd diagram
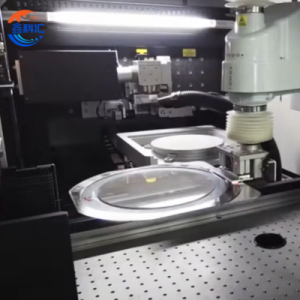
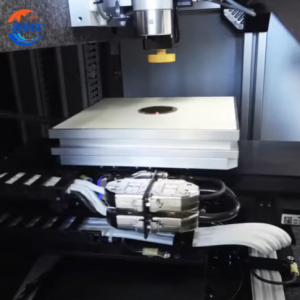
Productintroductie van halfgeleiderlaser-liftoff-apparatuur
De Semiconductor Laser Lift-Off Equipment is een zeer gespecialiseerde industriële oplossing, ontworpen voor het nauwkeurig en contactloos dunnen van halfgeleiderblokken door middel van lasergestuurde lift-off-technieken. Dit geavanceerde systeem speelt een cruciale rol in moderne halfgeleiderwafelprocessen, met name bij de fabricage van ultradunne wafers voor hoogwaardige vermogenselektronica, LED's en RF-componenten. Door de scheiding van dunne lagen van bulkblokken of donorsubstraten mogelijk te maken, revolutioneert de Semiconductor Laser Lift-Off Equipment het dunner maken van blokken door mechanisch zagen, slijpen en chemisch etsen overbodig te maken.
Het traditioneel dunnen van halfgeleiderblokken, zoals galliumnitride (GaN), siliciumcarbide (SiC) en saffier, is vaak arbeidsintensief, verspillend en gevoelig voor microscheurtjes of oppervlakteschade. Semiconductor Laser Lift-Off Equipment (SLLI) biedt daarentegen een niet-destructief en nauwkeurig alternatief dat materiaalverlies en oppervlaktespanning minimaliseert en tegelijkertijd de productiviteit verhoogt. Het ondersteunt een breed scala aan kristallijne en samengestelde materialen en kan naadloos worden geïntegreerd in de begin- of middenfase van halfgeleiderproductielijnen.
Met configureerbare laser golflengtes, adaptieve focussystemen en vacuümcompatibele waferhouders is deze apparatuur bijzonder geschikt voor het snijden van ingots, het creëren van lamellen en het losmaken van ultradunne films voor verticale apparaatstructuren of hetero-epitaxiale laagoverdracht.

Parameters van halfgeleiderlaser-liftoff-apparatuur
| Golflengte | IR/SHG/THG/FHG |
|---|---|
| Pulsbreedte | Nanoseconde, picoseconde, femtoseconde |
| Optisch systeem | Vast optisch systeem of galvano-optisch systeem |
| XY-stadium | 500 mm × 500 mm |
| Verwerkingsbereik | 160 mm |
| Bewegingssnelheid | Max. 1.000 mm/sec |
| Herhaalbaarheid | ±1 μm of minder |
| Absolute positienauwkeurigheid: | ±5 μm of minder |
| Wafergrootte | 2–6 inch of op maat gemaakt |
| Controle | Windows 10, 11 en PLC |
| Voedingsspanning | Wisselstroom 200 V ±20 V, eenfasig, 50/60 kHz |
| Externe afmetingen | 2400 mm (B) × 1700 mm (D) × 2000 mm (H) |
| Gewicht | 1.000 kg |
Werkingsprincipe van halfgeleiderlaser-liftoff-apparatuur
Het kernmechanisme van de Semiconductor Laser Lift-Off Equipment berust op selectieve fotothermische ontleding of ablatie aan het grensvlak tussen de donorstaaf en de epitaxiale of doellaag. Een hoogenergetische UV-laser (doorgaans een KrF-laser met een golflengte van 248 nm of solid-state UV-lasers rond 355 nm) wordt gefocusseerd door een transparant of semi-transparant donormateriaal, waar de energie selectief wordt geabsorbeerd op een vooraf bepaalde diepte.
Deze gelokaliseerde energieabsorptie creëert een hogedruk-gasfase of thermische expansielaag op het grensvlak, wat de schone delaminatie van de bovenste wafer- of apparaatlaag van de ingotbasis initieert. Het proces wordt nauwkeurig afgestemd door parameters zoals pulsbreedte, laserfluorescentie, scansnelheid en focusdiepte in de z-as aan te passen. Het resultaat is een ultradunne plak – vaak in het bereik van 10 tot 50 µm – die schoon van de moederingot is gescheiden zonder mechanische slijtage.
Deze laserlift-off-methode voor het dunner maken van ingots voorkomt het snijverlies en de oppervlakteschade die gepaard gaan met diamantdraadzagen of mechanisch slijpen. Het behoudt ook de kristalintegriteit en vermindert de behoefte aan nabewerking, waardoor Semiconductor Laser Lift-Off Equipment een baanbrekend hulpmiddel is voor de productie van wafers van de volgende generatie.
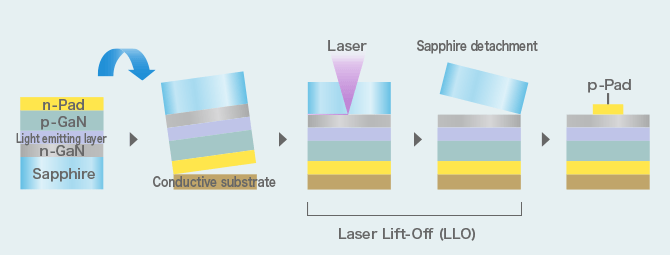
Toepassingen van halfgeleiderlaser-liftoff-apparatuur
Apparatuur voor het losmaken van halfgeleiderlasers vindt brede toepassing bij het dunner maken van ingots van diverse geavanceerde materialen en apparaattypen, waaronder:
-
Verdunning van GaN- en GaAs-ingots voor vermogenscomponenten
Maakt de productie van dunne wafers mogelijk voor zeer efficiënte, laagohmige vermogenstransistors en diodes.
-
Terugwinning van SiC-substraat en scheiding van lamellen
Maakt het mogelijk om wafers op waferschaal los te maken van massieve SiC-substraten voor verticale apparaatstructuren en hergebruik van wafers.
-
LED-wafels snijden
Maakt het mogelijk om GaN-lagen los te maken van dikke saffierblokken om ultradunne LED-substraten te produceren.
-
Fabricage van RF- en microgolfapparaten
Ondersteunt ultradunne HEMT-structuren (High-Electron-Mobility Transistor) die nodig zijn in 5G- en radarsystemen.
-
Epitaxiale laagoverdracht
Hiermee kunnen epitaxiale lagen nauwkeurig van kristallijne staven worden losgemaakt voor hergebruik of integratie in heterostructuren.
-
Dunnefilmzonnecellen en fotovoltaïsche cellen
Wordt gebruikt om dunne absorptielagen te scheiden voor flexibele of hoogrendementszonnecellen.
Op elk van deze gebieden biedt Semiconductor Laser Lift-Off Equipment ongeëvenaarde controle over dikteuniformiteit, oppervlaktekwaliteit en laagintegriteit.
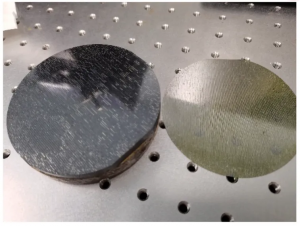
Voordelen van lasergestuurde ingotverdunning
-
Materiaalverlies bij nul snijkant
Vergeleken met traditionele methoden voor het snijden van wafers, resulteert het laserproces in een materiaalbenutting van bijna 100%.
-
Minimale spanning en kromtrekking
Contactloos afheffen elimineert mechanische trillingen, waardoor kromtrekking van de wafer en de vorming van microscheurtjes worden verminderd.
-
Behoud van oppervlaktekwaliteit
In veel gevallen is nabewerking door middel van lappen of polijsten niet nodig, omdat laserlift-off de integriteit van het bovenoppervlak behoudt.
-
Hoge doorvoer en klaar voor automatisering
Geschikt voor het verwerken van honderden substraten per shift met geautomatiseerd laden/lossen.
-
Geschikt voor diverse materialen
Compatibel met GaN, SiC, saffier, GaAs en opkomende III-V-materialen.
-
Milieuvriendelijker
Vermindert het gebruik van schuurmiddelen en agressieve chemicaliën die typisch zijn voor verdunningsprocessen op basis van slurry.
-
Hergebruik van substraten
Donorstaven kunnen meerdere keren hergebruikt worden, waardoor de materiaalkosten aanzienlijk lager worden.
Veelgestelde vragen (FAQ) over apparatuur voor het lift-off-proces van halfgeleiderlasers
-
Vraag 1: Welke diktebereiken kan de Semiconductor Laser Lift-Off Equipment bereiken voor waferplakken?
A1:De gebruikelijke plakdikte varieert van 10 µm tot 100 µm, afhankelijk van het materiaal en de configuratie.Vraag 2: Kan deze apparatuur worden gebruikt om staven van ondoorzichtige materialen zoals SiC te verdunnen?
A2:Ja. Door de laser golflengte aan te passen en de interface-engineering te optimaliseren (bijvoorbeeld door middel van opofferingslagen), kunnen zelfs gedeeltelijk ondoorzichtige materialen worden verwerkt.Vraag 3: Hoe wordt het donorsubstraat uitgelijnd vóór de laserlift-off?
A3:Het systeem maakt gebruik van op submicronniveau gebaseerde, op beeldherkenning gebaseerde uitlijnmodules met feedback van referentiepunten en scans van de oppervlaktereeflectiviteit.Vraag 4: Wat is de verwachte cyclustijd voor één laserlift-off-operatie?
A4:Afhankelijk van de grootte en dikte van de wafer duren typische cycli 2 tot 10 minuten.Vraag 5: Vereist het proces een cleanroomomgeving?
A5:Hoewel niet verplicht, wordt cleanroomintegratie aanbevolen om de reinheid van het substraat en de productopbrengst te waarborgen tijdens uiterst nauwkeurige bewerkingen.
Over ons
XKH is gespecialiseerd in de ontwikkeling, productie en verkoop van hoogwaardige optische glassoorten en nieuwe kristalmaterialen. Onze producten worden gebruikt in de optische elektronica, consumentenelektronica en de militaire sector. We bieden saffieren optische componenten, lenskappen voor mobiele telefoons, keramiek, LT, siliciumcarbide (SIC), kwarts en halfgeleiderkristalwafers. Dankzij onze expertise en geavanceerde apparatuur blinken we uit in de verwerking van niet-standaard producten en streven we ernaar een toonaangevende hightech onderneming in opto-elektronische materialen te worden.










