Hoewel zowel silicium- als glaswafers het gemeenschappelijke doel hebben om "gereinigd" te worden, verschillen de uitdagingen en faalmechanismen waarmee ze tijdens het reinigingsproces te maken krijgen aanzienlijk. Deze discrepantie vloeit voort uit de inherente materiaaleigenschappen en specificatie-eisen van silicium en glas, evenals de verschillende "filosofie" van reiniging die wordt bepaald door hun uiteindelijke toepassingen.
Laten we eerst eens duidelijkheid scheppen: wat maken we precies schoon? Welke verontreinigingen zijn erbij betrokken?
Verontreinigende stoffen kunnen in vier categorieën worden ingedeeld:
-
Deeltjesverontreinigingen
-
Stof, metaaldeeltjes, organische deeltjes, schurende deeltjes (van het CMP-proces), enz.
-
Deze verontreinigingen kunnen patroondefecten veroorzaken, zoals kortsluitingen of onderbrekingen.
-
-
Organische verontreinigingen
-
Bevat onder andere resten van fotolak, harsadditieven, menselijke huidoliën en oplosmiddelresten.
-
Organische verontreinigingen kunnen maskers vormen die etsen of ionenimplantatie belemmeren en de hechting van andere dunne films verminderen.
-
-
Metaalionverontreinigingen
-
IJzer, koper, natrium, kalium, calcium, enz., die voornamelijk afkomstig zijn van apparatuur, chemicaliën en menselijk contact.
-
In halfgeleiders zijn metaalionen "killer"-verontreinigingen. Ze introduceren energieniveaus in de verboden band, wat de lekstroom verhoogt, de levensduur van ladingsdragers verkort en de elektrische eigenschappen ernstig aantast. In glas kunnen ze de kwaliteit en hechting van daaropvolgende dunne films beïnvloeden.
-
-
Natuurlijke oxidelaag
-
Voor siliciumwafers: Op het oppervlak vormt zich van nature een dunne laag siliciumdioxide (natuurlijke oxide). De dikte en uniformiteit van deze oxidelaag zijn moeilijk te controleren en deze moet volledig worden verwijderd tijdens de fabricage van belangrijke structuren zoals gate-oxiden.
-
Voor glaswafers: Glas zelf is een siliciumdioxide-netwerkstructuur, dus er is geen probleem met het "verwijderen van een natuurlijke oxidelaag". Het oppervlak kan echter door verontreiniging zijn aangetast, en deze laag moet wel worden verwijderd.
-

I. Kerndoelen: De divergentie tussen elektrische prestaties en fysieke perfectie
-
Siliciumwafels
-
Het belangrijkste doel van reiniging is het waarborgen van de elektrische prestaties. Specificaties omvatten doorgaans strikte eisen aan het aantal en de grootte van de deeltjes (bijvoorbeeld deeltjes ≥0,1 μm moeten effectief worden verwijderd), de concentratie van metaalionen (bijvoorbeeld Fe en Cu moeten worden beperkt tot ≤10¹⁰ atomen/cm² of lager) en de hoeveelheid organische resten. Zelfs microscopische verontreiniging kan leiden tot kortsluiting, lekstromen of aantasting van de integriteit van de gate-oxide.
-
-
Glazen wafers
-
Als ondergrond zijn de belangrijkste eisen fysieke perfectie en chemische stabiliteit. Specificaties richten zich op aspecten op macroniveau, zoals de afwezigheid van krassen en onuitwisbare vlekken, en het behoud van de oorspronkelijke oppervlakteruwheid en -geometrie. Het doel van de reiniging is voornamelijk om visuele reinheid en een goede hechting te garanderen voor latere processen zoals het aanbrengen van een coating.
-
II. Materiaaleigenschappen: Het fundamentele verschil tussen kristallijn en amorf
-
Silicium
-
Silicium is een kristallijn materiaal en op het oppervlak groeit van nature een ongelijkmatige siliciumdioxide (SiO₂) oxidelaag. Deze oxidelaag vormt een risico voor de elektrische prestaties en moet grondig en gelijkmatig worden verwijderd.
-
-
Glas
-
Glas is een amorf siliciumdioxide-netwerk. Het basismateriaal heeft een samenstelling die vergelijkbaar is met de siliciumoxide-laag van silicium, waardoor het snel geëtst kan worden door fluorwaterstofzuur (HF) en ook gevoelig is voor sterke alkalische erosie, wat leidt tot een toename van de oppervlakteruwheid of vervorming. Dit fundamentele verschil zorgt ervoor dat bij het reinigen van siliciumwafers een lichte, gecontroleerde etsing mogelijk is om verontreinigingen te verwijderen, terwijl bij het reinigen van glaswafers uiterste zorgvuldigheid geboden is om beschadiging van het basismateriaal te voorkomen.
-
| Schoonmaakartikel | Reiniging van siliciumwafels | Reiniging van glazen wafers |
|---|---|---|
| Schoonmaakdoel | Bevat een eigen, natuurlijke oxidelaag. | Selecteer reinigingsmethode: Verwijder verontreinigingen en bescherm tegelijkertijd het basismateriaal. |
| Standaard RCA-reiniging | - SPM(H₂SO₄/H₂O₂): Verwijdert organische/fotolakresten | Hoofdreinigingsproces: |
| - SC1(NH₄OH/H₂O₂/H₂O): Verwijdert deeltjes van het oppervlak | Zwak alkalisch reinigingsmiddelBevat actieve oppervlakteactieve stoffen om organische verontreinigingen en deeltjes te verwijderen. | |
| - DHF(Fluorwaterstofzuur): Verwijdert de natuurlijke oxidelaag en andere verontreinigingen. | Sterk alkalisch of matig alkalisch reinigingsmiddelWordt gebruikt om metaalachtige of niet-vluchtige verontreinigingen te verwijderen. | |
| - SC2(HCl/H₂O/H₂O): Verwijdert metaalverontreinigingen | Vermijd HF gedurende de hele periode. | |
| Belangrijke chemicaliën | Sterke zuren, sterke basen, oxiderende oplosmiddelen | Zwak alkalisch reinigingsmiddel, speciaal samengesteld voor het verwijderen van lichte vervuiling. |
| Fysieke hulpmiddelen | Gedemineraliseerd water (voor zeer zuiver spoelen) | Ultrasoon, megasonisch reinigen |
| Droogtechnologie | Megasonic, IPA-dampdroging | Voorzichtig drogen: Langzaam optillen, drogen met IPA-damp. |
III. Vergelijking van reinigingsoplossingen
Afhankelijk van de bovengenoemde doelstellingen en materiaaleigenschappen verschillen de reinigingsoplossingen voor silicium- en glaswafers:
| Reiniging van siliciumwafels | Reiniging van glazen wafers | |
|---|---|---|
| Schoonmaakdoel | Grondige verwijdering, inclusief de natuurlijke oxidelaag van de wafer. | Selectieve verwijdering: verontreinigingen verwijderen en tegelijkertijd het substraat beschermen. |
| Typisch proces | Standaard RCA-zuivering:•SPM(H₂SO₄/H₂O₂): verwijdert zware organische stoffen/fotolak •SC1(NH₄OH/H₂O₂/H₂O): alkalische deeltjesverwijdering •DHF(verdund HF): verwijdert de natuurlijke oxidelaag en metalen •SC2(HCl/H₂O/H₂O): verwijdert metaalionen | Kenmerkende reinigingsprocedure:•Milde alkalische reinigermet oppervlakteactieve stoffen om organische stoffen en deeltjes te verwijderen •Zure of neutrale reinigervoor het verwijderen van metaalionen en andere specifieke verontreinigingen •Vermijd HF gedurende het hele proces. |
| Belangrijke chemicaliën | Sterke zuren, sterke oxidatiemiddelen, alkalische oplossingen | Milde alkalische reinigingsmiddelen; speciale neutrale of licht zure reinigingsmiddelen. |
| Fysieke ondersteuning | Megasonisch (zeer efficiënte, zachte deeltjesverwijdering) | Ultrasoon, megasonisch |
| Drogen | Marangoni drogen; IPA-dampdroging | Langzaam trekkend drogen; IPA-dampdrogen |
-
Reinigingsproces van glazen wafers
-
Momenteel gebruiken de meeste glasverwerkingsbedrijven reinigingsprocedures die gebaseerd zijn op de materiaaleigenschappen van glas, waarbij voornamelijk gebruik wordt gemaakt van zwakke alkalische reinigingsmiddelen.
-
Kenmerken van reinigingsmiddelen:Deze gespecialiseerde reinigingsmiddelen zijn doorgaans zwak alkalisch, met een pH van ongeveer 8-9. Ze bevatten meestal oppervlakteactieve stoffen (bijvoorbeeld alkylpolyoxyethyleenether), metaalchelerende middelen (bijvoorbeeld HEDP) en organische reinigingshulpmiddelen, ontworpen om organische verontreinigingen zoals oliën en vingerafdrukken te emulgeren en af te breken, terwijl ze de glasmatrix minimaal aantasten.
-
Processtroom:Het gebruikelijke reinigingsproces omvat het gebruik van een specifieke concentratie zwak alkalische reinigingsmiddelen bij temperaturen variërend van kamertemperatuur tot 60 °C, in combinatie met ultrasone reiniging. Na de reiniging ondergaan de wafers meerdere spoelstappen met zuiver water en een voorzichtige droging (bijvoorbeeld langzaam optillen of drogen met IPA-damp). Dit proces voldoet effectief aan de eisen voor visuele reinheid en algemene reinheid van de glazen wafers.
-
-
Reinigingsproces van siliciumwafels
-
Voor de verwerking van halfgeleiders ondergaan siliciumwafers doorgaans een standaard RCA-reiniging, een zeer effectieve reinigingsmethode die alle soorten verontreinigingen systematisch aanpakt en ervoor zorgt dat aan de elektrische prestatie-eisen voor halfgeleidercomponenten wordt voldaan.
-
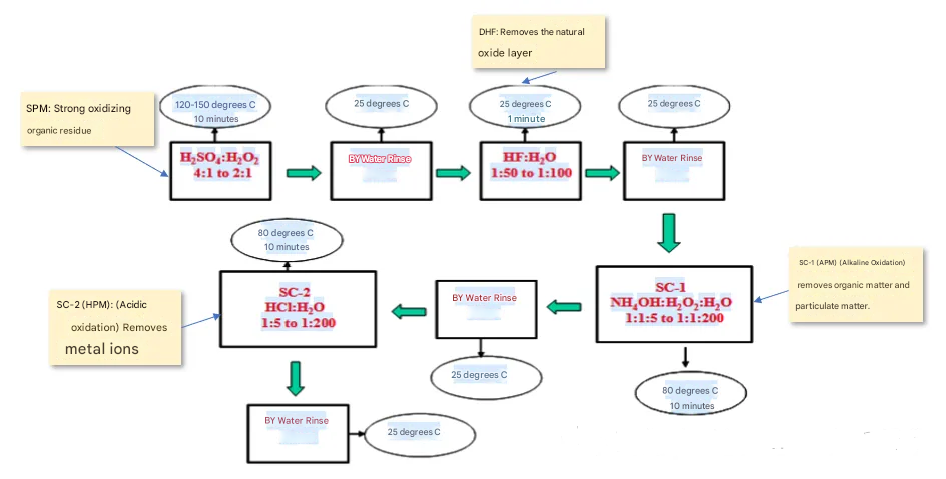
IV. Wanneer glas aan hogere ‘reinheids’-normen voldoet
Wanneer glazen wafers worden gebruikt in toepassingen die strenge eisen stellen aan het aantal deeltjes en de metaalionenconcentratie (bijvoorbeeld als substraten in halfgeleiderprocessen of voor het creëren van uitstekende oppervlakken voor de afzetting van dunne films), is het intrinsieke reinigingsproces mogelijk niet langer voldoende. In dat geval kunnen de reinigingsprincipes voor halfgeleiders worden toegepast, waarbij een aangepaste RCA-reinigingsstrategie wordt geïntroduceerd.
De kern van deze strategie is het verdunnen en optimaliseren van de standaard RCA-procesparameters om rekening te houden met de gevoelige aard van glas:
-
Verwijdering van organische verontreinigingen:SPM-oplossingen of milder ozonwater kunnen worden gebruikt om organische verontreinigingen af te breken door middel van sterke oxidatie.
-
Deeltjesverwijdering:Een sterk verdunde SC1-oplossing wordt gebruikt bij lagere temperaturen en kortere behandeltijden om de elektrostatische afstoting en micro-etsende effecten ervan te benutten voor het verwijderen van deeltjes, terwijl corrosie van het glas tot een minimum wordt beperkt.
-
Verwijdering van metaalionen:Een verdunde SC2-oplossing of eenvoudige verdunde zoutzuur-/salpeterzuuroplossingen worden gebruikt om metaalverontreinigingen te verwijderen door middel van chelatie.
-
Strikte verboden:DHF (diammoniumfluoride) moet absoluut vermeden worden om corrosie van het glazen substraat te voorkomen.
In het gehele gemodificeerde proces verbetert de combinatie met megasonische technologie de verwijderingsefficiëntie van nanodeeltjes aanzienlijk en is het oppervlak bovendien milder.
Conclusie
De reinigingsprocessen voor silicium- en glaswafers zijn het onvermijdelijke resultaat van reverse engineering, gebaseerd op hun uiteindelijke toepassingsvereisten, materiaaleigenschappen en fysische en chemische kenmerken. Bij de reiniging van siliciumwafers wordt gestreefd naar "reinheid op atomair niveau" voor optimale elektrische prestaties, terwijl bij de reiniging van glaswafers de focus ligt op het verkrijgen van "perfecte, onbeschadigde" fysieke oppervlakken. Naarmate glaswafers steeds vaker worden gebruikt in halfgeleidertoepassingen, zullen de reinigingsprocessen onvermijdelijk verder evolueren dan de traditionele reiniging met zwakke alkalische oplossingen. Er zullen meer verfijnde, op maat gemaakte oplossingen worden ontwikkeld, zoals het gemodificeerde RCA-proces, om aan hogere reinheidsnormen te voldoen.
Geplaatst op: 29 oktober 2025
